B stage高分子树脂材料种类与应用
[发布日期:2020-09-04 11:29:57] 点击:
高分子树脂材料种类
热塑型(thermoplastic)
热塑型材料为高分子材料中,具有加热时材料会软化,冷却后会固化之特性。
树脂中的分子链都是线性或带有支链的结构,软化固化现象可交替反复进行,所以可回收再利用并可被特定溶剂溶解.
热固型(thermoset)
热固型材料为交联结构之材料具有加热固化后无法被溶剂溶解,亦无法于加热过程中软化,使用后不易被回收及再利用.
玻璃转移温度 (glass transition temperature, Tg)
高分子树脂材料为许多单体(oligomer)聚合而成,再到达某特定温度时,材料会从刚硬的玻璃态(glass
state)变成柔软的橡胶状(rubber state),此温度称为玻璃转移温度.
高分子树脂材料在低于玻璃转移温度及高于此温度时的热膨胀系数会有明显的变化,一般单一材料则无此现象.
何谓 B stage材料
热固性树脂的固化反应可分成A/B/C三个阶段.
A Stage
树脂处于反应的初期,因低聚合程度因此分子量还是很低,材料呈现液体的态状.
B Stage
树脂持续反应,大部份结构呈现线性及部份交联(cross-link)状态,分子量较大到呈现半固化状况,此阶段材料可以被特定溶剂溶解,在特定温度下材料可以流动或融化,此阶段在某些树脂反应并不明显.
C Stage
此阶段为树脂反应后期,分子结构呈现网状交联结构,材料无法再加热融化,亦无法被溶剂所溶解,为材料固化反应后最后状态,表面通常无黏著性,具有稳定的Tg.
B stage材料应用
B stage
材料由于呈现半固化状态,具良好的加工性及可控制的黏性,在室温下能够保存数个月之久,借由与被著材料一起加热、加压,能够容易的熔融黏合,再透过进一步加热进行固化,发挥高度的黏合密合密封性.
Die Attach Film(芯片黏著胶带)
相较于传统所使用的液态接著胶,将液态接著胶涂布于基材上并予以B
stage化,再贴合于wafer后进行加工黏合,可精确控制接著胶流动状况/胶层厚度,贴合过程中因表面平整性产生胶层内之气泡,可使用ELT科技所生产之真空压力除泡烤箱来加以消除, 达到良好稳定的良率及可靠度表现.
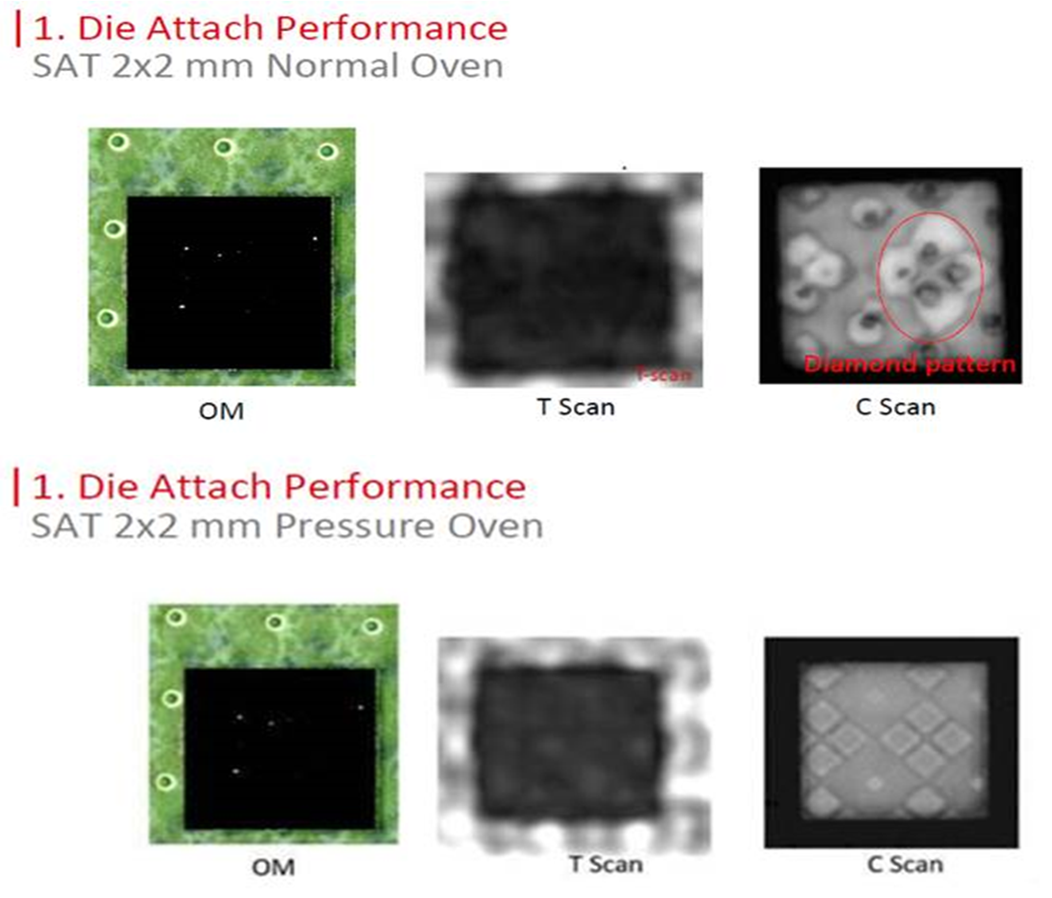
B stage材料应用
NCF(Non-conductive Film)
在覆晶制程中,大部份使用Underfill(底部填充材)来填充于覆晶与基板之间的空隙,固化后借此保护之间的连结.
由于制程中额外助焊剂的残留及底部填充材之气泡,使得产品良率及可靠性受到影响.
利用NCF胶带取代底部填材可免除助焊剂清洁制程,ELT科技所生产的真空压膜机,透过真空及可控温之压合气囊,准确的贴合NCF胶带,消除贴合时的气泡产生,适合用于生产高阶的电子封装产品如HBM(High
bandwidth emory)及chip on wafer,提供佳的生产品质及良率.
Die attach paste for DRAM package(Window
BGA)
在Window BGA的封装制程中,晶粒(die)的黏著胶为使用B stage
环氧树脂黏著胶,使用方式为利用钢板(stencil)
将 A stage 黏著胶印刷于基板上再进行B stage烘烤,最后置晶并进行C
stage最后固化.由于印刷时胶层表面不平整,
容易于置晶后产生voids,利用ELT科技所制造之真空压力除泡系统,可轻易的去除制程中所产生之气泡,提供良好的良率及可靠度保证.